실리콘 기판 가공 공정과 세정 장치
세정 목적
-
전 공정에서의 세정:공정 중 발생한 오염물 제거가 주요 목적이 된다.
-
후 공정에서의 세정:파티클 제거 및 금속 제거가 주요 목적이 된다.
대표적인 세정 방법은 RCA 세정이라 불리는 세정 방법이다.
RCA 세정의 목적
반도체 제조에서 수율을 100%까지 높이는 것이 최대 목표가 된다. 수율에 크게 영향을 미치는 것은 파티클과 금속 오염이다. 파티클은 배선의 단선이나 쇼트의 원인이 된다. 금속은 노이즈의 주요 요인이 된다. 이러한 요인들이 수율에 뚜렷한 영향을 미친다.
배치식 전자동 웨이퍼 세정기 전체도

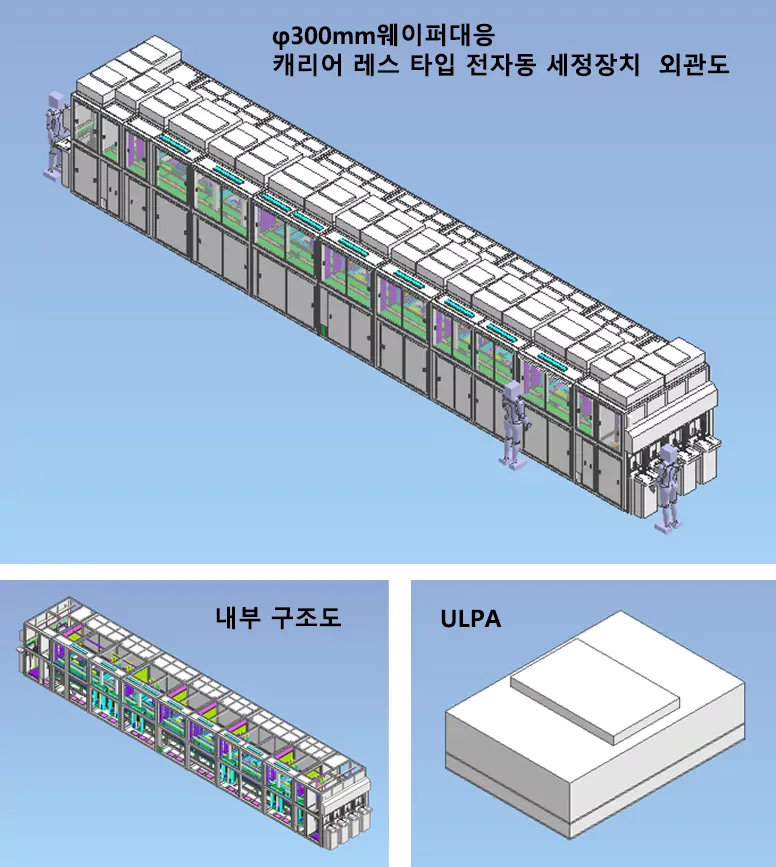

RCA 세정이란
-
APM(SC-1) 세정:파티클 제거를 목적으로 한 세정 방법. NH4OH + H2O2 + DIW
-
APM(SC-2) 세정:금속 제거를 목적으로 한 세정 방법. HCl + H2O2 + DIW
-
DHF 세정:파티클 제거 / 금속 제거를 목적으로 한 세정 방법. HF + DIW
-
SPM 세정:유기물 제거를 목적으로 한 세정 방법. H2SO4 + H2O2
실리콘 기판 제조 공정
(적색 글씨 제품 목록)
| 공정 | 내용 |
|---|---|
| 단결정 | CZ법, MCZ법, FZ법 |
| 결정 외주 연삭 방향 측정 | 외주 연삭 결정 방향을 알 수 있도록 오리플랫 또는 노치 가공을 실시 |
| 슬라이스 |
다이아몬드 블레이드: 소경 웨이퍼 와이어 톱: Ø8, Ø12 유리 연마재, 유성 연마재, 수성 연마재 고정 연마재: 와이어에 연마재를 고착 (소 마크가 발생하기 쉬움) |
| 슬라이스 후 세정 |
연마재 제거. 알칼리 + 계면활성을 주로 한 세정 Ø12의 경우 디마운터를 통해 실시: 웨이퍼 세정 및 박리 |
| 베벨링 | 웨이퍼 단면의 가공 및 연마를 실시. |
| 랩 | 양면 랩 장비를 사용하여 웨이퍼를 평탄하게 처리. |
| 랩 후 세정기 | 랩핑 연마재 제거. 알칼리 + 계면활성을 주로 한 세정. |
| 에칭 |
랩 가공 시 발생한 가공 변형을 제거함. 산 에칭(확산 속도 제한): HF, HNO3, CH3COOH 혼합 산액 알칼리 에칭(반응 속도 제한): KOH 또는 NaOH 농축액 |
| 그라인딩 | Ø12 웨이퍼의 경우 래핑 대신 그라인딩으로 평탄도를 높이는 방법. 양두 연삭과 단면 연삭이 있음. |
| 알칼리 에칭 | 그라인딩으로 인해 발생한 가공 변형의 제거 |
| 열처리 전 세정 | RCA 세정이 기본이지만, 사용자의 라인 구성에 따라 다를 수 있음 |
| 열처리 |
게터링 BSD: 웨이퍼 뒷면에 가공으로 인해 변형층을 형성하여 게터링 작용을 하게 함 열처리: 열처리를 통해 웨이퍼 내부에 변형층을 형성함. 다양한 방법이 있음 |
| 열처리 후 세정 | RCA 세정이 기본이지만, 사용자의 라인 구성에 따라 다를 수 있음 |
| 폴리싱(연마) |
거울면 연마: 웨이퍼 표면의 요철을 극한까지 없앰 양면 연마: Ø12는 양면 연마 단면 연마: Ø8까지는 단면 연마가 주 |
| 연마 후 세정 | 폴리싱 후 세정: RCA 세정이 기본 DHF, SC-1, SC-2, O3물 |
| 파티클 검사 | KLA (Tencor) SP3 |
| 최종 세정 | RCA 세정을 기본으로 DHF, SC-1, SC-2, O3 물을 사용. |