矽基板加工工程與清洗設備
清洗目的
-
前製程的清洗:主要目的是去除製程中產生的污染物。
-
後製程的清洗:主要目的是去除微粒以及金屬污染物。
代表性的清洗方法稱為RCA清洗。
RCA清洗的目的
在半導體製造過程中,將良率提升至100%是最大的目標。影響良率的主要因素為微粒和金屬污染。微粒可能導致配線斷裂或短路,金屬則是造成噪音的主要原因。這些因素會明顯影響良率。
批次式全自動晶圓清洗機整體圖

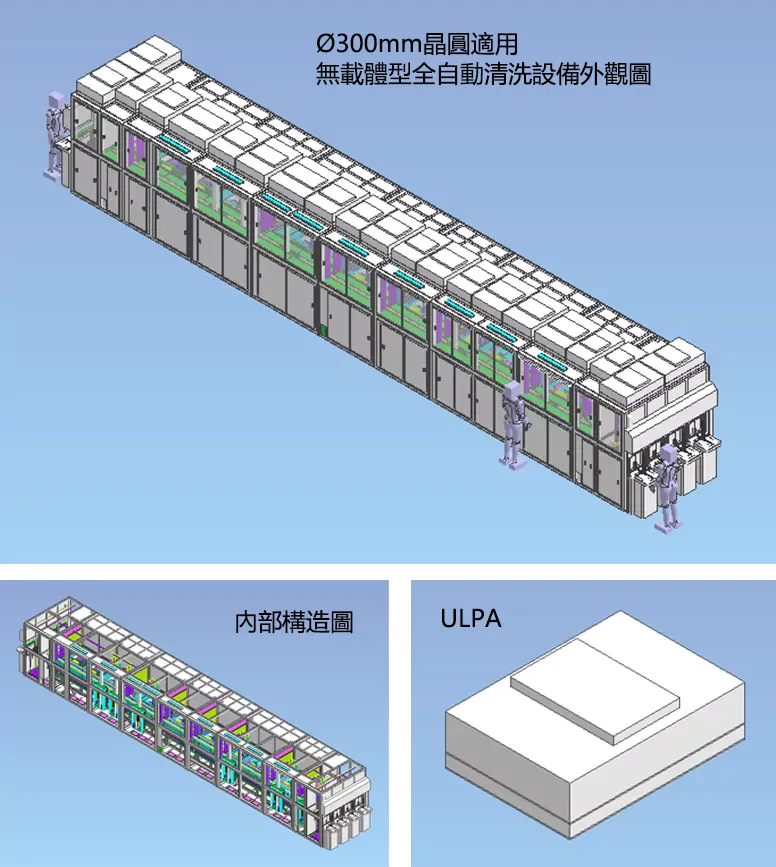

什麼是RCA清洗
- APM(SC-1)清洗:以去除微粒為目的的清洗方法。NH4OH + H2O2 + DIW
- APM(SC-2)清洗:以去除金屬污染為目的的清洗方法。HCl + H2O2 + DIW
- DHF清洗:以去除微粒/金屬污染為目的的清洗方法。HF + DIW
- SPM清洗:以去除有機物為目的的清洗方法。H2SO4 + H2O2
矽基板製造流程
(紅字產品線列表)
| 工程 | 內容 |
|---|---|
| 單晶 | CZ法、MCZ法、FZ法 |
| 晶體外圍研磨方位測定 | 外圍研磨 為了確認晶體方位,進行切削加工或刻槽處理 |
| 切片 |
鑽石刀片:小直徑晶圓 線鋸:Ø8、Ø12 游離研磨粒子、油性研磨粒子、水性研磨粒子 固定研磨粒子:將研磨粒子固定於線鋸上(容易產生鋸痕) |
| 切片後清洗 |
去除研磨粒子。以鹼性 + 表面活性劑為主進行清洗 Ø12的情況下,使用分離機進行:晶圓清洗及剝離 |
| 倒角 | 進行晶圓邊緣的加工及研磨。 |
| 研磨 | 雙面研磨機:使晶圓表面平坦。 |
| 包裝後清洗機 | 去除包裝研磨粒子:以鹼性+界面為主的清洗方式 |
| 蝕刻 |
去除包裝加工時所產生的加工變形。 酸性蝕刻(擴散速率控制):HF, HNO3, CH3COOH混合酸液 鹼性蝕刻(反應速率控制):KOH或NaOH的濃縮液 |
| 研磨 | 針對Ø12晶圓,以研磨取代拋光來提升平坦度的方法。 分為雙面研磨與單面研磨。 |
| 鹼性蝕刻 | 去除研磨過程中產生的加工應力 |
| 熱處理前清洗 | 以RCA清洗為基礎,但會因使用者的生產線配置而有所不同 |
| 熱處理 |
捕獲效應 BSD:在晶圓背面形成加工引起的應力層,以產生捕獲效應。 熱處理:透過熱處理在晶圓內部形成應力層,有多種方法可實現。 |
| 熱處理後清洗 | 以RCA清洗為基礎,但會因使用者的生產線配置而有所不同 |
| 拋光(研磨) |
鏡面研磨:將晶圓表面的凹凸降至極限。 雙面研磨:Ø12採用雙面研磨 單面研磨:Ø8以下主要採用單面研磨 |
| 研磨後清洗 | 拋光後清洗:以RCA清洗為基礎,包含DHF、SC-1、SC-2、O3水 |
| 微粒檢測 | KLA (Tencor) SP3 |
| 最終清洗 | 以RCA清洗為基礎,包含DHF、SC-1、SC-2、O3水 |